封装基板或中间层是BGA封装中非常重要的部分,除了用于互连布线以外,还可用于阻抗控制及用于电感/电阻/电容的集成。因此要求基板材料具有高的玻璃转化温度rS(约为175~230℃)、高的尺寸稳定性和低的吸潮性,具有较好的电气性能和高可靠性。金属薄膜、绝缘层和基板介质间还要具有较高的粘附性能。
1.线键合PBGA的封装工艺流程
(1)BGA基板的制备
在BT树脂/玻璃芯板的两面层压极薄(12~18μm厚)的铜箔,然后进行钻孔和通孔金属化。用常规的PCB加3232艺在基板的两面制作出图形,如导带、电极、及安装焊料球的焊区阵列。然后加上焊料掩膜并制作出图形,露出电极和焊区。为提高生产效率,一条基片上通常含有多个PBG基板。
(2)工艺流程
圆片减薄→圆片切削→芯片粘结→等离子清洗→引线键合→等离子清洗→模塑封装→装配焊料球→回流焊→表面打标→分离→最终检查→测试斗包装 芯片粘结采用充银环氧粘结剂将IC芯片粘结在基板上,然后采用金线键合实现芯片与基板的连接,接着模塑包封或液态胶灌封,以保护芯片、焊接线和焊盘。使用特殊设计的吸拾工具将熔点为183℃、直径为30mil(0.75mm)的焊料球62/36/2Sn/Pb/Ag或63/37/Sn/Pb放置在焊盘上,在传统的回流焊炉内进行回流焊接,最高加工温度不能够超过230℃。接着使用CFC无机清洗剂对基片实行离心清洗,以去除残留在封装体上的焊料和纤维颗粒,其后是打标、分离、最终检查、测试和包装入库。
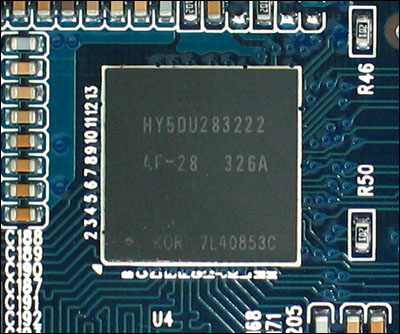
BGA封装
2.C-CBGA的封装工艺流程
(1)CBGA基板
FC-CBGA基板是多层陶瓷基板,它的制作是相当困难的。因为基板的布线密度高、间距窄、通孔也多,以及基板的共面性要求较高等。它的主要过程是:先将多层陶瓷片高温共烧成多层陶瓷金属化基片,再在基片上制作多层金属布线,然后进行电镀等。在CBGA的组装中,基板与芯片、PCB电路板的CTE失配是造成CBGA产品失效的主要因素。要改善这一情况,除采用CCGA结构外,还可使用另外一种陶瓷基板--HITCE陶瓷基板。
(2)工艺流程
圆片凸点的制备呻圆片切割呻芯片倒装及回流焊-)底部填充呻导热脂、密封焊料的分配+封盖斗装配焊料球-)回流焊斗打标+分离呻最终检查斗测试斗包装。
3.线键合TBGA的封装工艺流程
(1)BGA载板
TBGA载板通常是由聚酰亚胺材料制成的。在制作时,先在载带的两面进行覆铜,然后镀镍和镀金,接着冲通孔和通孔金属化及制作出图形。因为在这种引线键合TBGA中,封装热沉又是封装的加固体,也是管壳的芯腔基底,因此在封装前先要使用压敏粘结剂将载带粘结在热沉上。
(2)封装工艺流程
圆片减薄→圆片切割→芯片粘结→清洗→引线键合→等离子清洗→液态密封剂灌封→装配焊料球→回流焊→表面打标→分离→最终检查→测试→包装。
