PCB沉头孔加工深度控制技术详解:高精度公差0.03mm(普通0.05mm)、一致性0.02mm;采用TiAlN涂层硬质合金刀具、分层加工策略、恒温环境控制与激光实时检测。覆盖5G基站通讯设备、汽车电子高温场景,提供深度...

LTCC 技术:高端电子封装领域的材料革新与应用突破
LTCC 技术通过 850-900℃低温共烧工艺,介电损耗(28GHz)低至 0.002、耐温 - 200℃至 250℃,集成密度 800 个 / 平方厘米,适配 5G/6G 通信、新能源汽车、航空航天领域,凭借低损耗粉...
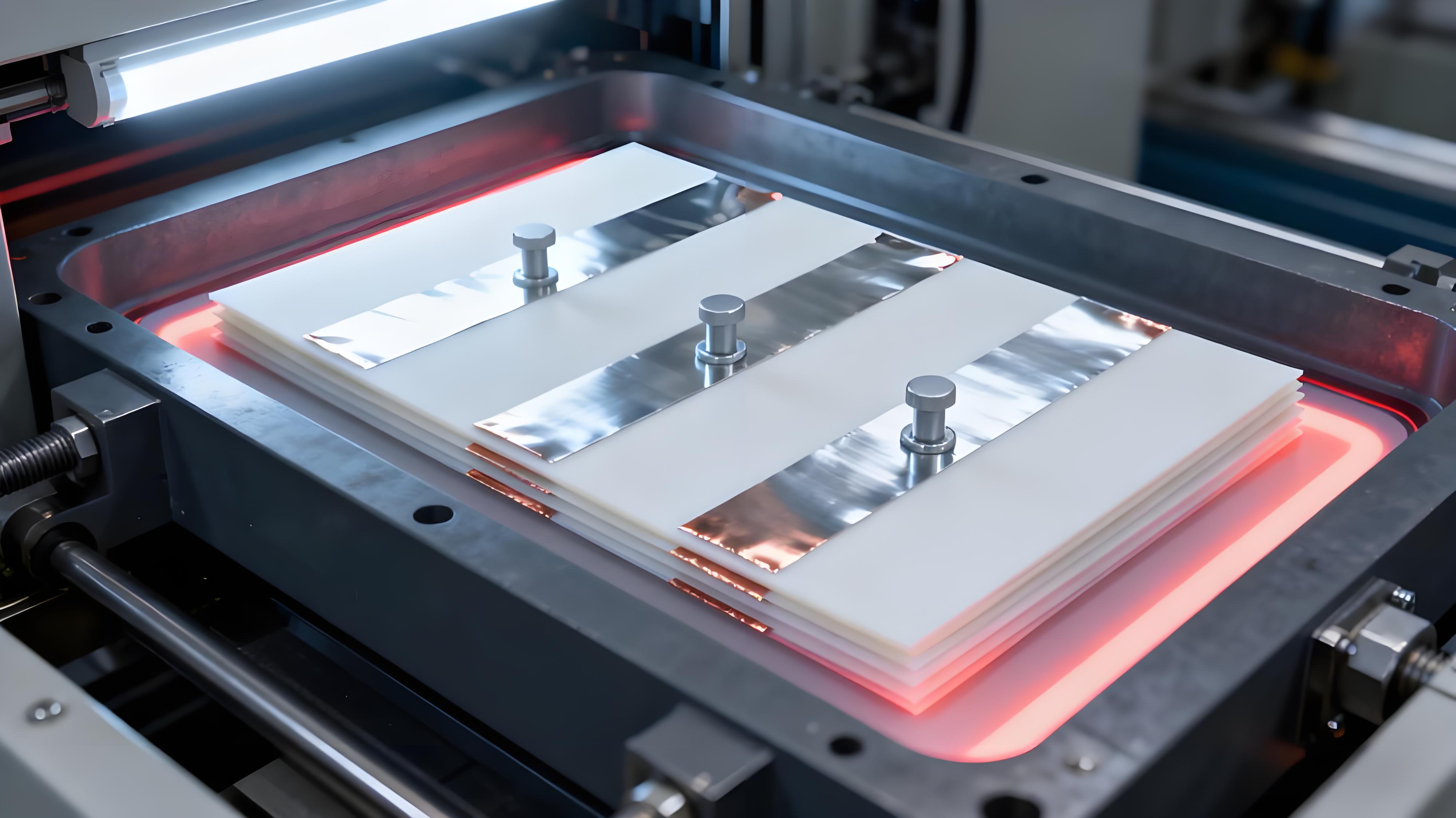
聚四氟乙烯PCB加工难点及解决方案深度解析 -ibpcb
聚四氟乙烯(PTFE)PCB 是 5G 通信、航空航天、微波射频领域高频首选基材,因低表面能、高热膨胀系数等存加工难点,通过等离子体 / 钠萘处理、陶瓷填充板材、180Krpm + 高转速钻孔、375℃-390℃层压及 ...
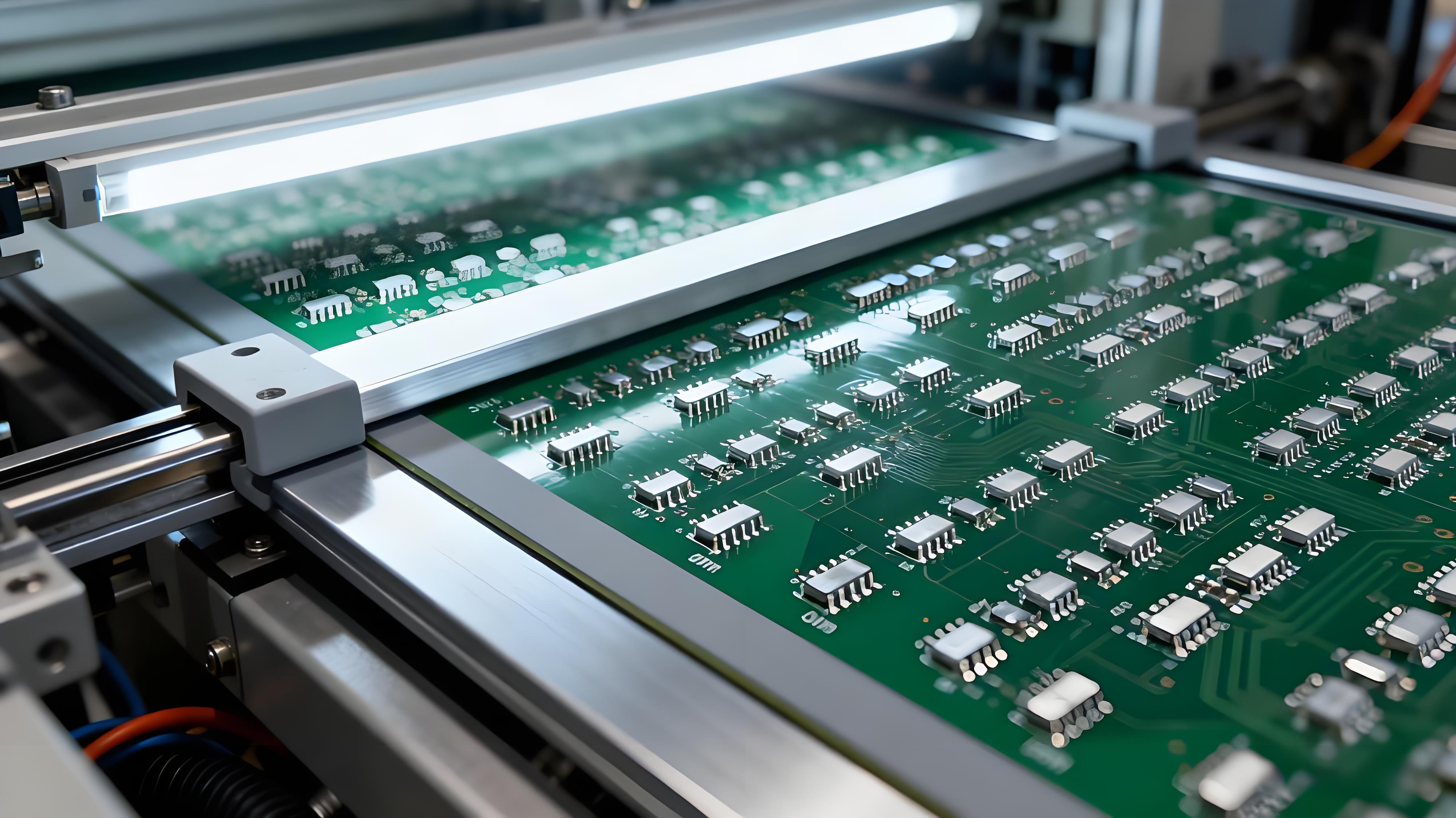
PCB 拼板设计规范:从基础原则到实操细节的技术指南
PCB 拼板设计规范全指南:含尺寸适配设备(利用率75%)、V-Cut / 邮票孔 / 桥连三种连接方式、基准点偏差 0.05mm 等核心参数,适配 SMT、焊接、测试等工艺,规避开裂、虚焊等问题,赋能手机主板、模块板等...

选择性焊接技术:PCB 复杂焊点精准焊接的应用场景解析
选择性焊接技术针对复杂多层PCB(厚度1.6-2.0mm)实现精准焊点焊接,覆盖01005/BGA(0.3mm直径)/QFP(0.2mm间距)等微型元件及大功率连接器。适用于汽车电子(ADAS/OBC,宽温振动)、医疗设...

